
封装测试是将生产出来的合格晶圆进行切割、焊线、塑封,使芯片电路与外部器件实现电气连接,为芯片提供机械物理保护,并利用测试工具,对封装完的芯片进行功能和性能测试。
封测环节,意义重大
获得一颗IC芯片,要经过从设计到制造漫长的流程,然而一颗芯片相当小且薄,如果不在外施加保护,会被轻易的刮伤损坏。

封测有着安放、固定、密封、保护芯片和增强电热性能的作用,而且还是沟通芯片内部世界与外部电路的桥梁——芯片上的接点用导线连接到封测外壳的引脚上,这些引脚又通过印制板上的导线与其他器件建立连接。因此,封测对集成电路起着重要的作用。
封测的主要流程
晶圆代工厂制造完成的晶圆在出厂前会经过一道电性测试,称为晶圆可接受度测试(Wafer Acceptance Test,WAT),WAT 测试通过的晶圆将被送去封测厂。
封测厂首先对晶圆进行中测(Chip Probe,CP)。由于工艺原因会引入各种制造缺陷,导致晶圆上的裸 Die 中会有一定量的残次品, CP 测试的目的就是在封装前将这些残次品找出来,缩减后续封测的成本。
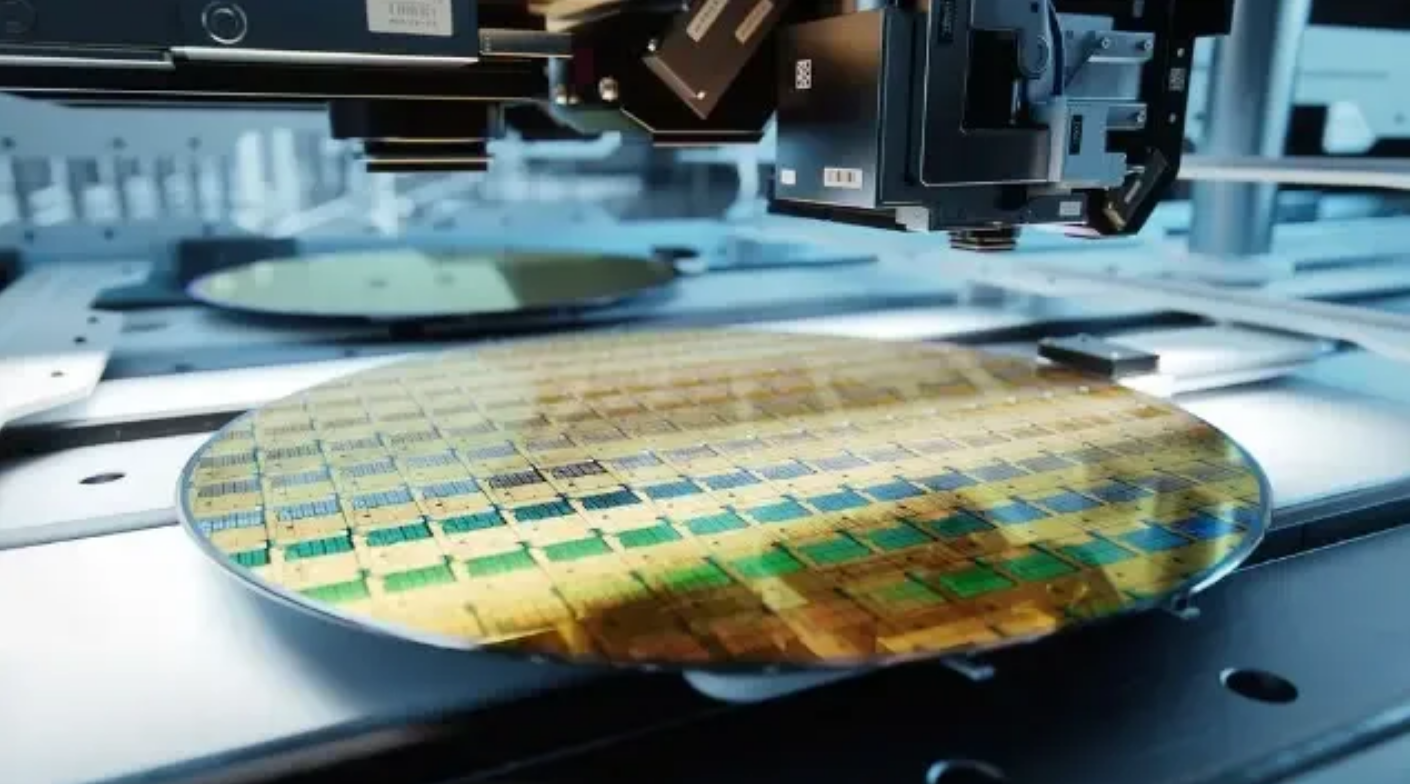
在完成晶圆制造后, 通过探针与芯片上的焊盘接触,进行芯片功能的测试,同时标记不合格芯片,并在切割后进行筛选。
气浮平台,应用于晶圆切割
探针台由载物台、光学元件、卡盘组成,主要承担输送定位任务,使晶圆依次与探针接触完成测试,提供晶圆自动上下片、找中心、对准、定位,及按照设计的步距移动晶圆以使探针卡上的探针能对准硅片相应位置进行测试。
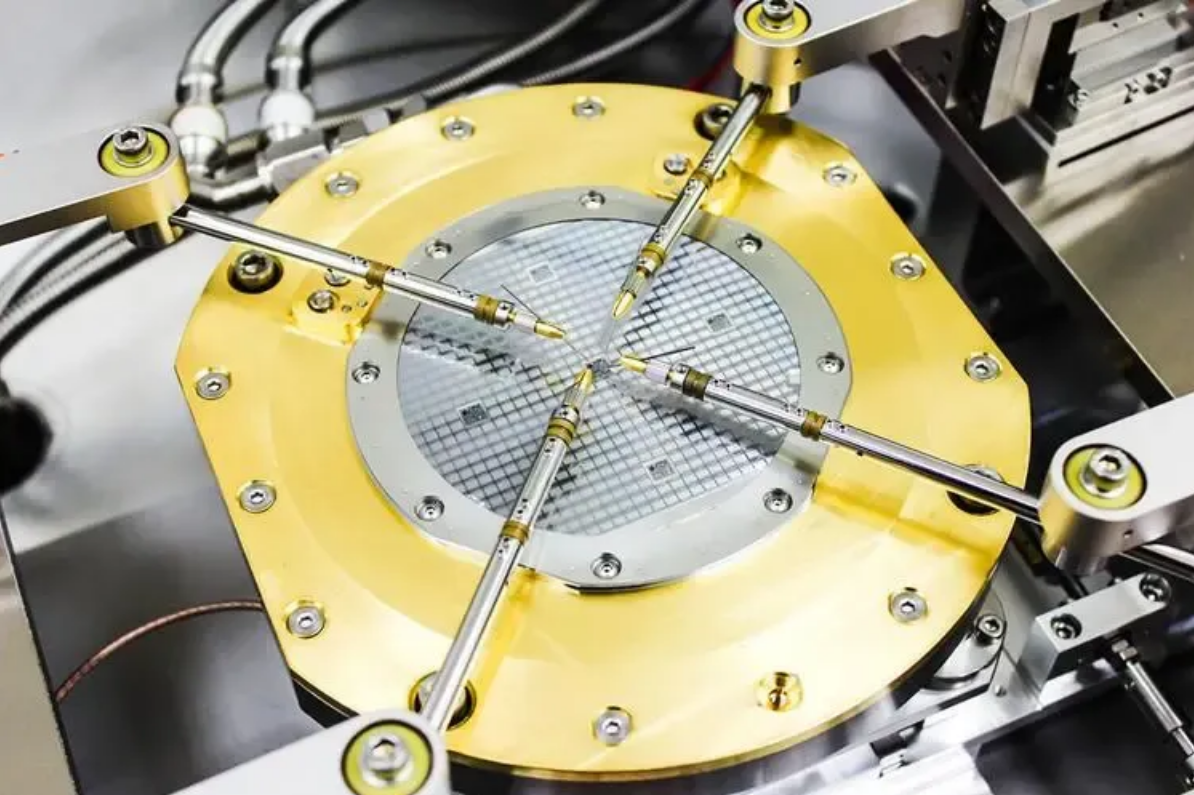
载物台是定位晶圆或芯片的部件设备,通常会根据晶圆的尺寸来设计大小,并配套了相应的精密移动定位功能。自主研发的超精密气浮平台是作为载物平台,重复定位精度达±50nm,提供超精密的机械移动定位,以定位晶圆进行精密检测。
以上CP 测试完成后,进入封装环节,封装工艺流程一般可以分为两个部分,用塑料封装之前的工艺步骤称为前段操作,在成型之后的工艺步骤称为后段操作。
封测的主要工艺流程:
一、前段
晶圆减薄(wafer grinding):刚出场的晶圆(wafer)进行背面减薄,达到封装需要的厚度。在背面磨片时,要在正面粘贴胶带来保护电路区域。研磨之后,去除胶带。
晶圆切割(wafer Saw):将晶圆粘贴在蓝膜上,再将晶圆切割成一个个独立的Dice,再对Dice进行清洗。
光检查:检查是否出现残次品
芯片贴装(Die Attach):芯片贴装,银浆固化(防止氧化),引线焊接。
二、后段
注塑:防止外部冲击,用EMC(塑封料)把产品封测起来,同时加热硬化。
激光打字:在产品上刻上相应的内容。例如:生产日期、批次等等。
高温固化:保护IC内部结构,消除内部应力。
去溢料:修剪边角。
电镀:提高导电性能,增强可焊接性。
切片成型检查残次品。
这就是一个完整芯片封测的过程。因封装技术不同,工艺流程会有所差异,且封装过程中也会进行检测。封装完成后的产品还需要进行终测 (Final Test,FT),通过 FT 测试的产品才能对外出货。
免责声明:本文系网络转载或改编,版权归原作者所有。但因转载众多,无法确认真正原始作者,故标明转载来源。如涉及版权等问题,请与我们联系删除!本文内容为原作者观点,并不代表本网站赞同其观点和对真实性负责。
分享