
引线键合(Wire Bonding)是MEMS器件封装中最为主要的内部连接方式,目前占比超过90%,它通过极细的金属丝(通常直径在18~50μm),利用热、压力、超声波能量或其组合,使金属引线与MEMS芯片焊盘及基板焊盘发生原子量级上的键合,实现芯片与外部电路的电气互连和信号传输。MEMS芯片的引线键合主要采用IC芯片的键合技术,基本过程是首先将金属线的端点烧结成小球,压焊在芯片的焊点上(第一焊点),然后按照设计路径拉线,最后压焊在基板对应的焊点上(第二焊点),同时拉断线并形成新的小球,为下一条线做准备。键合类型主要包括热压键合、超声键合和热超声键合,这三种键合技术本文不详述。

图 引线过程示意
常见的键合引线材料有金(Au)、铝(Al)、铜(Cu)以及银(Ag)合金线,Au线化学性能稳定,不易氧化,导电性好,可塑性好,工艺最成熟,但是Au价格昂贵,且与铝焊盘易形成金属间化合物,影响长期可靠性;Al线价格低,但是易氧化,机械强度较低,电阻率较高;热导性较差,焊点较大;Cu线极易氧化,键合需更大超声能量和压力,一般在在中低端产品中应用较多。
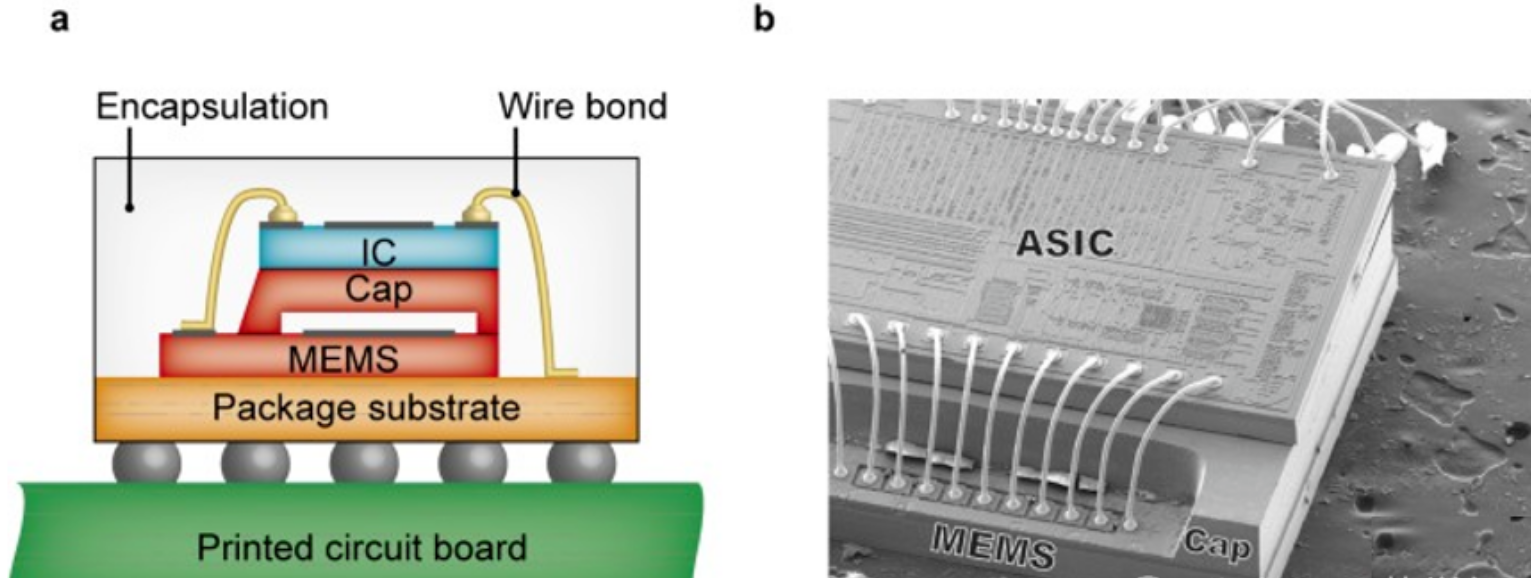
图MEMS芯片引线键合示意
在MEMS中,常见的引线直径范围在18μm~50μm(约0.7mil~2mil)之间,焊盘的材质最常见的是Al焊盘,在高可靠性应用场景还有Au焊盘,焊盘边长应至少为引线球焊直径的1.5倍,根据经验数据,对于直径在25 µm到50µm范围内的引线,最小焊盘尺寸通常设计在60µm×60µm到100µm×100µm之间,对于细间距应用,相邻焊盘的边缘间距通常要求至少为25 µm。
对于压力传感器的核心是感应压力的薄膜,键合过程中的热量和机械应力可能会传递到薄膜上,导致传感器零点漂移或灵敏度变化,因此,应优先选择低温键合工艺如热超声键合,并优化引线弧度以减小对芯片的应力。RF MEMS开关用于处理高频信号,引线本身具有寄生电感和电容,会影响信号质量,为最小化这些寄生效应,引线必须尽可能短,弧高(Loop Height)必须尽可能低且一致。光学器件如MEMS微镜键合线的位置和弧高不能遮挡光路或干扰光学信号。加速度计和陀螺仪内部含有可移动的质量块和精密的悬挂结构,对外部的机械冲击和振动极为敏感,键合时的超声振动可能会损坏这些结构。
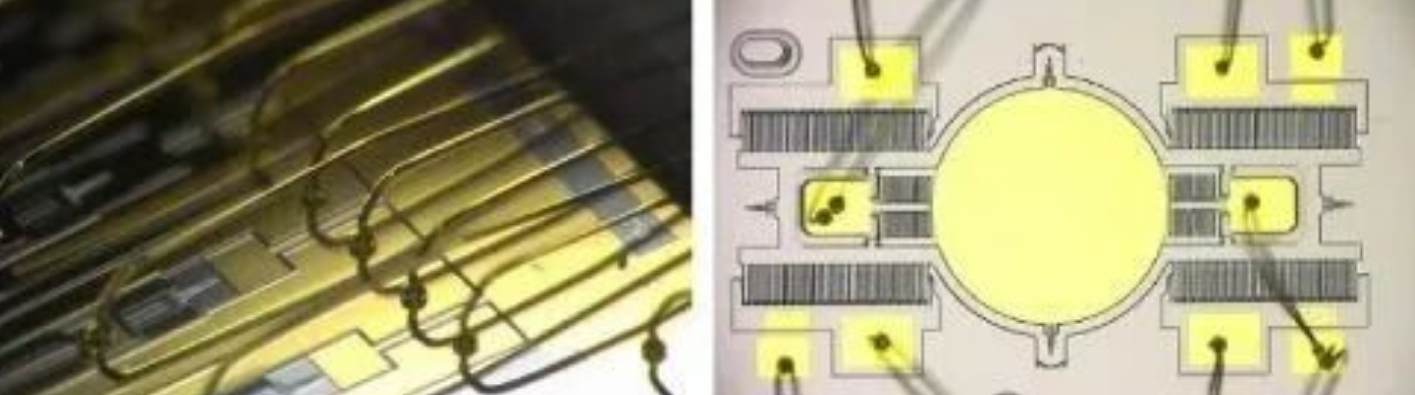
图 光学器件微镜引金线键合
免责声明:本文系网络转载或改编,版权归原作者所有。但因转载众多,无法确认真正原始作者,故标明转载来源。如涉及版权等问题,请与我们联系删除!本文内容为原作者观点,并不代表本网站赞同其观点和对真实性负责。
分享