
芯片封装的功能作用
芯片封装是将半导体前段制程加工完成的晶圆经过切割、粘贴、键合加工后,再用塑封材料包覆,达到保护芯片组件并用于线路板(Printed Circuit Board, PCB)的组装装配过程(见图)。芯片封装颗粒主要是提供一个引线键合的接口,通过金属引脚、球形接点等技术连接到芯片系统,并保护芯片免于外部环境包括外力、水、杂质或化学物等的破坏和腐蚀。
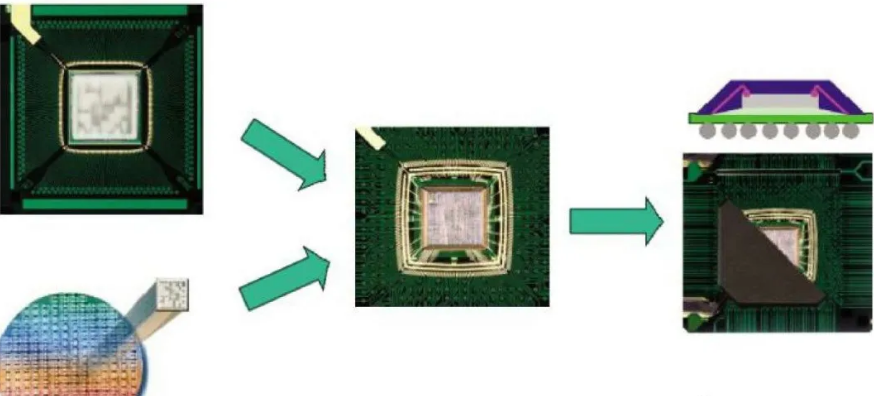
图 芯片封装功能结构示意图
芯片封装的目的在于确保芯片经过封装之后具有较强的机械性能、良好的电气性能和散热性能。一个完整科学的芯片封装工艺过程,首先应当满足实现集成电路芯片内键合点和外部电气连接的目的,其次还应为芯片提供一个长期稳定可靠的工作环境,不仅对芯片起到机械和环境保护的作用,而且还要保证芯片正常工作的高稳定性和可靠性。
芯片封装的主要功能作用可概括为以下几点:
(1)传递电能。
所有电子产品都以电为能源,电能的传递包括电源电压的分配和导通,在封装过程中对于电能传递的主要考量是将不同部位的器件和模块所需的不同大小的电压进行恰当的分配,以避免不必要的电损耗,同时兼顾考虑地线分配问题。电能的传送必须经过线路的连接才能实现,这是芯片封装的主要功能作用。(见图)
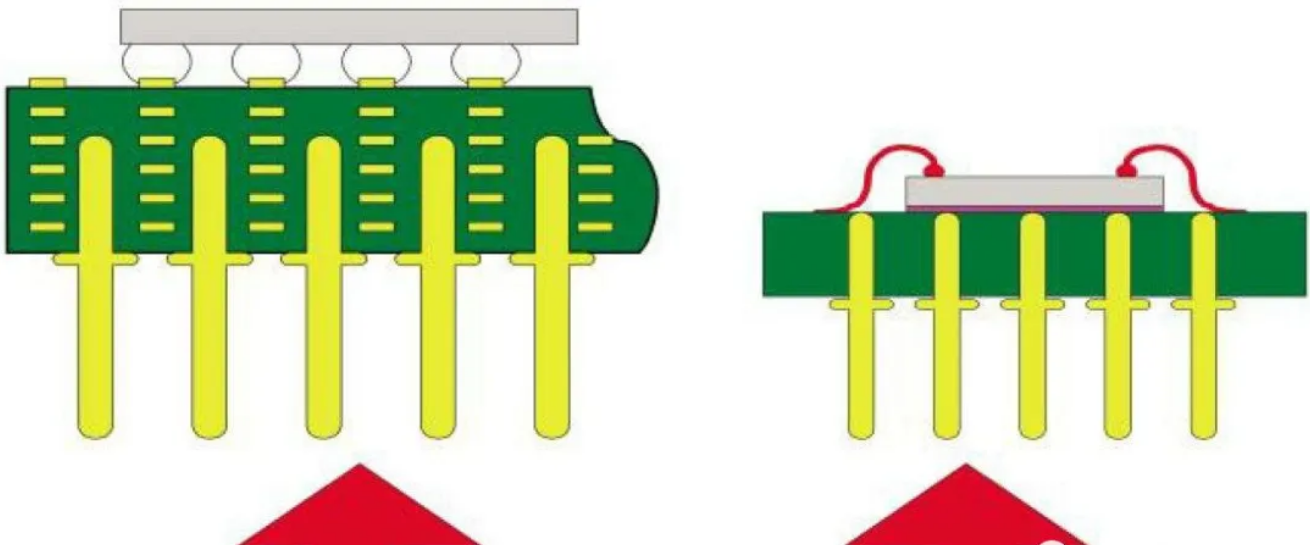
图 芯片封装传递电能结构示意图
(2)传递电信号。
集成电路产生的电信号或外部输入的电信号,需通过封装将不同层之间的线路传递到正确的位置,这些线路不仅要保证电信号的延迟尽可能小,而且还要保证传递的路径达到最短。因此在经过芯片封装使各线路连接后,各电子组件间的电信号传递既有效也高效。(见图)
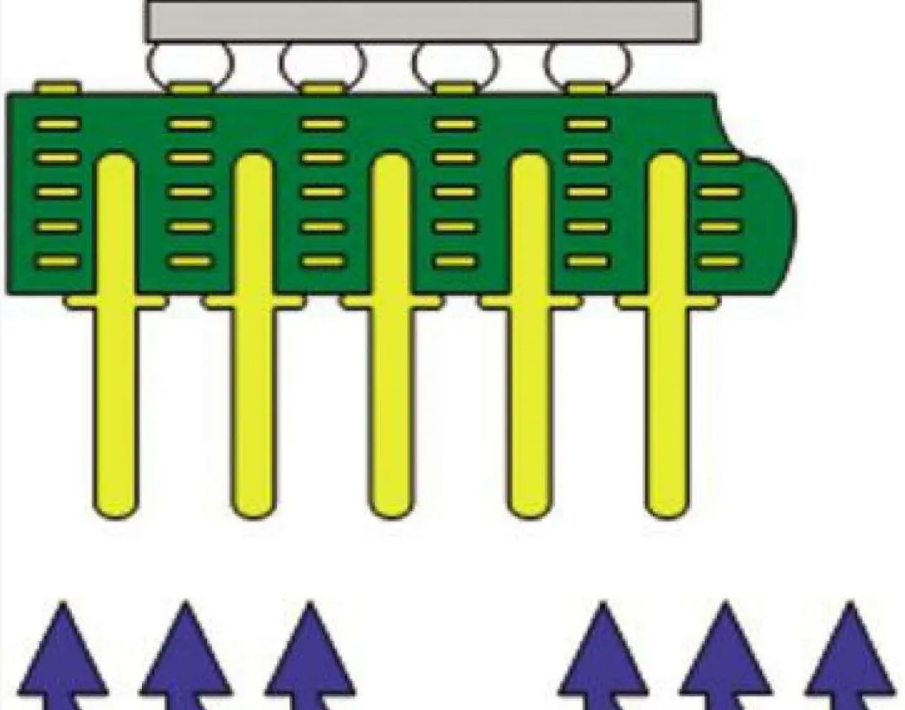
图 芯片封装传递电信号结构示意图
(3)散热。
集成电路的各元器件、部件、模块在长时间工作时会产生一定的热量。芯片封装就是利用封装材料良好的导热性能将电路间产生的热量有效地散失,使芯片在合适的工作温度下正常工作并达到各项性能指标的要求,不致因工作环境温度积累过高而造成电路的毁损。(见图)
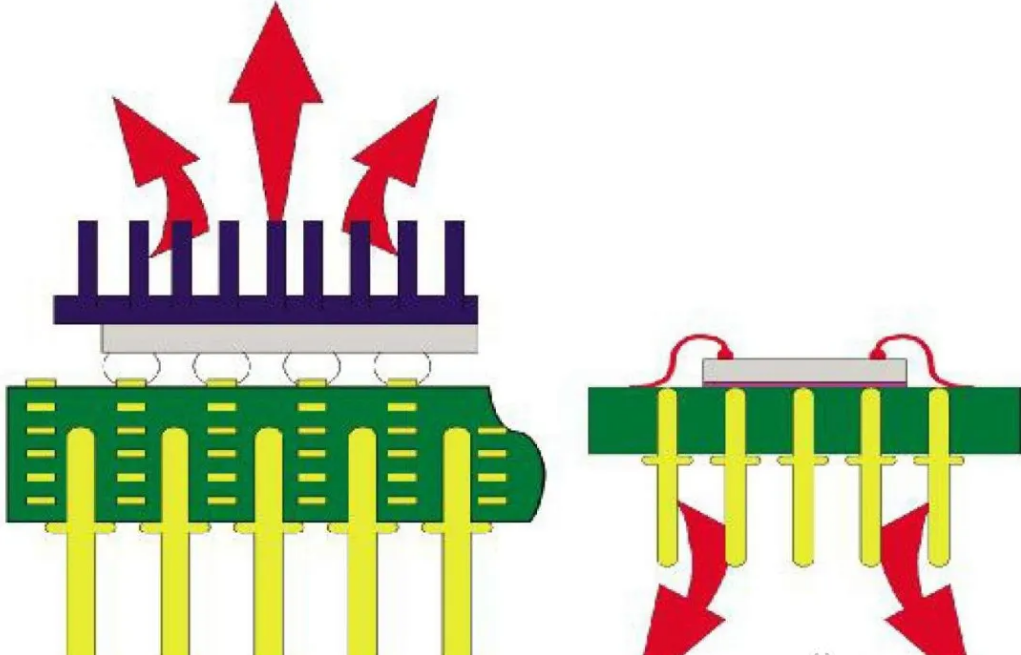
图 芯片封装散热结构示意图
(4)电路保护。
有效的电路保护不仅需要为芯片和其他连接部件之间提供可靠的机械支撑,而且还要确保精细的集成电路不受外界物质的污染。芯片封装为集成电路的稳定性和可靠性提供了良好的结构性保护和支持。(见图)
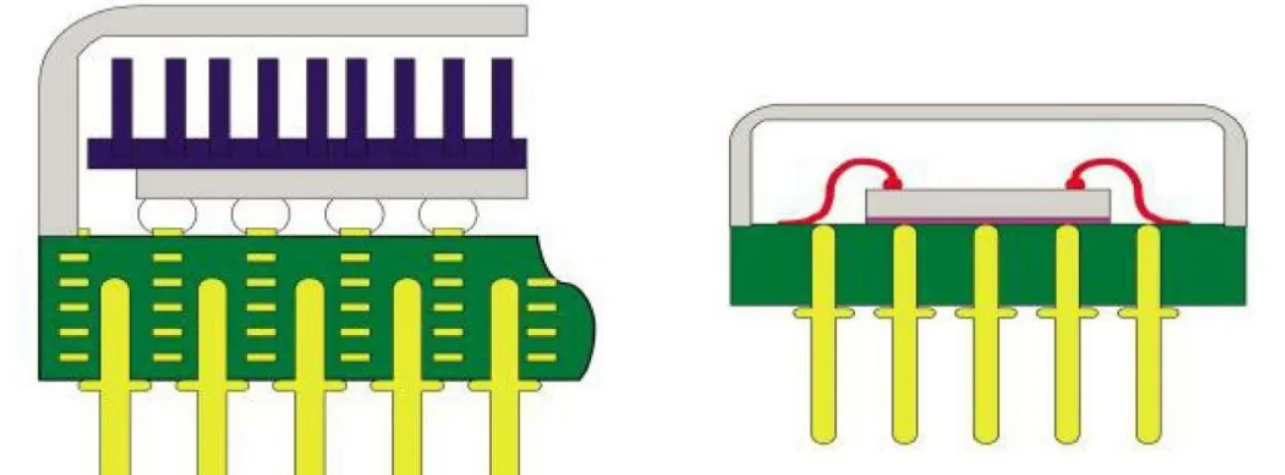
图 芯片封装电路保护结构示意图
(5)系统集成。
多个芯片可以通过封装工艺集成整合为一,科学的封装工艺不仅减少了电路之间连接的焊点数量,而且可以显著减小封装体积和重量,同时缩短组件之间的连接线路,整体提高了集成电路的电性能。(见图)
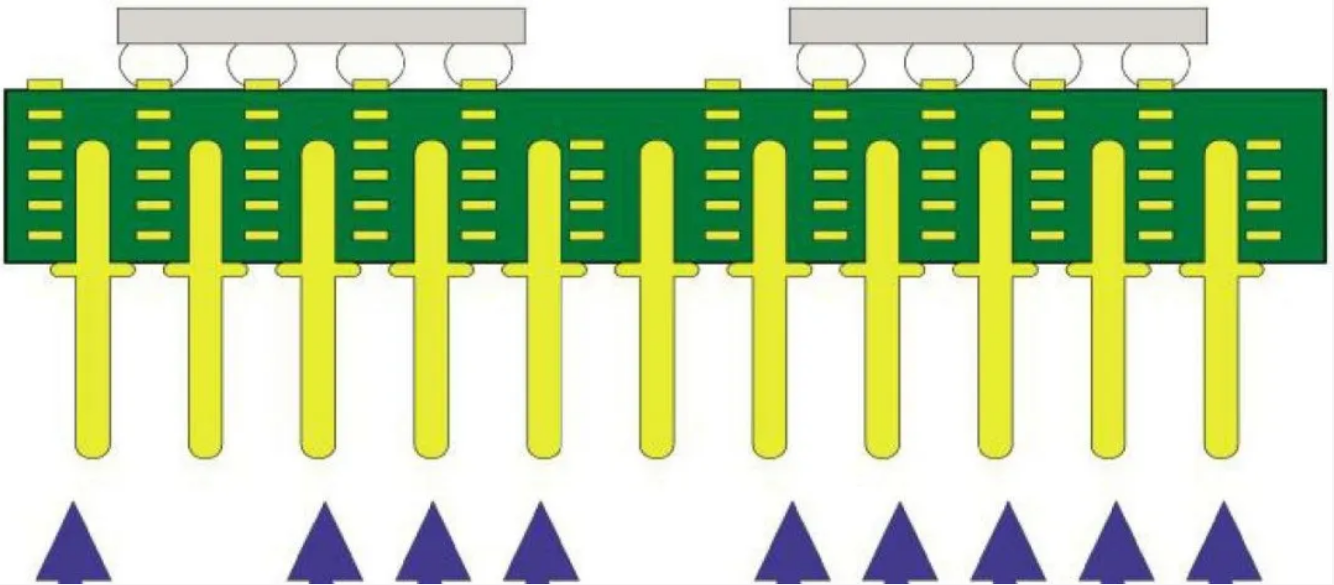
图 芯片封装系统集成结构示意图
电子封装的层级分类
根据芯片的基本制造过程可将电子封装划分为三个阶段。
一阶封装,指将集成电路芯片制作出来后,对芯片键合塑封的封装过程阶段;
二阶封装,指将封装完成的芯片颗粒组装到模块或线路板上的封装过程阶段;
三阶封装,指将模块或线路板安装到母板或系统板上的封装过程阶段。最后,不同的系统装配起来,制造成不同的电子终端产品。
封装产业发展到现在,随着混合电子电路(Hybrid Microelectronic)技术的发展,一阶与二阶封装的行业界线随着封装技术的发展已逐渐变得模糊。例如,芯片直接组装(Chip on Board, CoB)省略了一阶封装,使得整个封装变得更加紧凑。
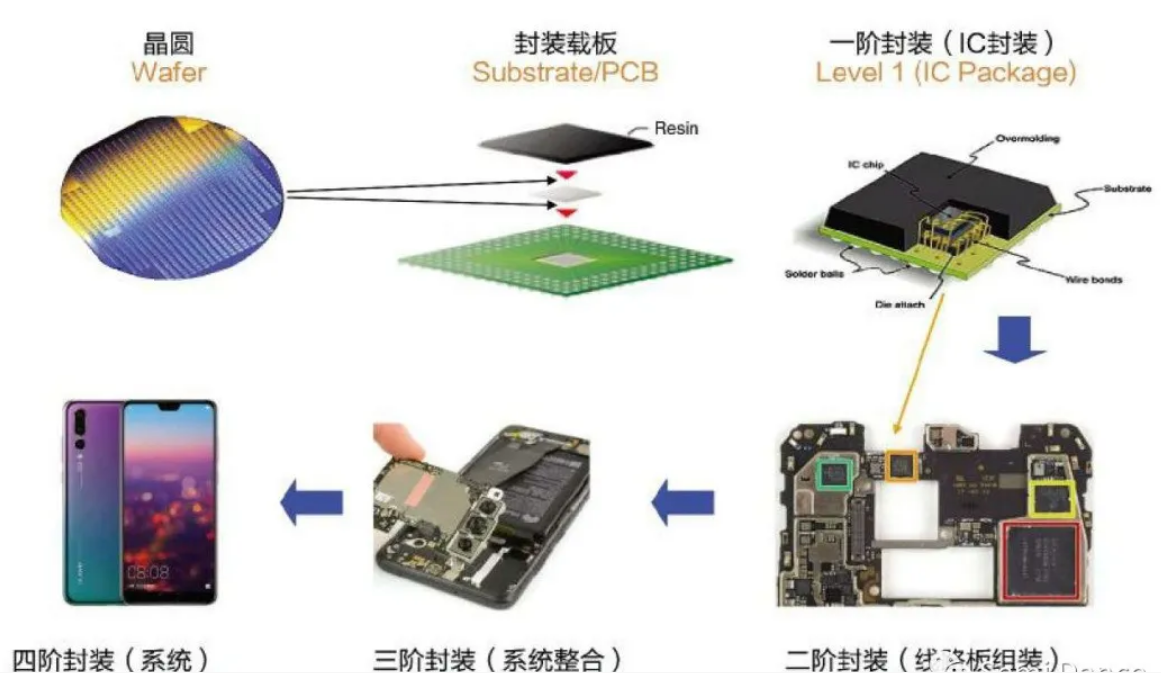
图 电子封装阶段划分示意图
芯片封装的制造工艺
芯片封装制造通常是由封装测试厂来生产测试,过程中有许多步骤会重复交叉进行,不同的芯片一般加工顺序及工艺都有所区别,一般而言封装生产线制造流程大致如下:圆片减薄→圆片切削→芯片粘贴→清洗→引线键合→清洗→模塑封装→裁切成型→装配焊料球→回流焊→打标→分离→检查及测试→包装。(见图)其中重点制造节点介绍如下:
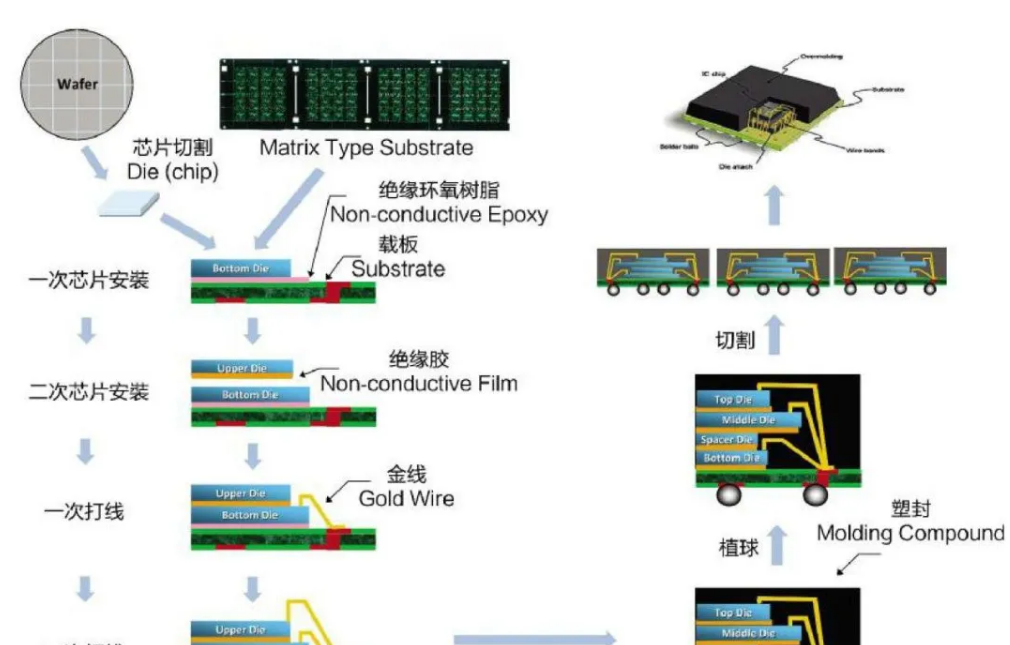
图 芯片封装工序流程示意图
(1)封装前测试。
在封装上线生产前会先对芯片进行电性测试,测试结果可以判断芯片颗粒是否达到正常工作的质量指标要求,测试结果正常的芯片才能进行下一步封装工序,测试结果不正常的芯片则打上墨水记号另行处理。
(2)芯片颗粒切割。
用钻石切割锯片将晶圆上的芯片颗粒沿着切割线切开,形成一颗颗方形的芯片。
(3)芯片粘贴。
采用导电银浆等黏结剂将芯片粘贴在镀有金属镍/金薄层的载板上。
(4)引线键合(Wire Bonding, WB)封装或倒装芯片(Flip Chip, FC)封装。
用机械钢嘴将金线一端加压固定在芯片四周围的焊盘上,另一端加压固定在载板的金属接脚上,让芯片上的焊区与载板上镀有镍/金层的焊区相连。同理,也可以经由倒装芯片封装的方法,让芯片上的焊区与载板上镀有锡合金层的焊区以焊料球相连。
(5)塑封。
将引线键合后的芯片与载板放在铸模内,注入环氧树脂后再烘烤硬化模塑包封,塑封其实就是将芯片完全包覆起来,以隔绝外界的水汽与污染,以保护芯片、焊接线及焊盘。
(6)裁切成型。
用机械工具将多余的环氧树脂去除,并将塑料外壳裁切成所需的形状,裁切成型后就得到黑色方体的集成电路IC了。
(7)植球和回流焊。
使用特别设计的吸拾工具(焊球自动拾放机)将浸有助焊剂的焊料锡球放置在载板的焊盘上,在传统的回流焊炉内,在氮气(N2)环境下进行回流焊接,使锡球与载板焊区焊接。
(8)全功能测试。
全功能测试包括符合规格的完全测试与精密的产品寿命参数测试等,以确保集成电路符合质量标准。
(9)打标/激光印字。
将产品的制造商、品名、批号与制造日期等信息通过激光技术打印在封装外壳表面作为辨识标记,激光是高能量的光束,可以将文字直接刻写在封装外壳上。(见图)

图封装后的芯片实物展示图
(10)封装后测试。
集成电路的封装后测试是将测试用的电子信号,经由载板上的金属接脚输入集成电路,再经由金线传送到焊盘,流入芯片,然后经过芯片内部运算后的结果,再由另外某些焊盘送出,最后由另外的金线传送到载板上的球形接脚输出,我们可以由这些输出的电子信号来判断集成电路是否正常工作。封装后测试是芯片发货前最后的测试工作,另外包括脚位扫描检查、品质抽样测试等,通过测试的集成电路就可以按照合格成品包装发货销售了。
免责声明:本文系网络转载或改编,版权归原作者所有。如涉及版权等问题,请与我们联系删除!本文内容为原作者观点,并不代表本公众号赞同其观点和对真实性负责。
分享